BGA元件维修步骤
第一步:
必须确保焊垫的吃锡特性及平整度,方能保证后之可靠度
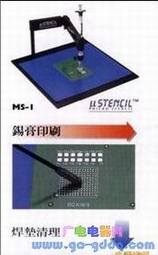
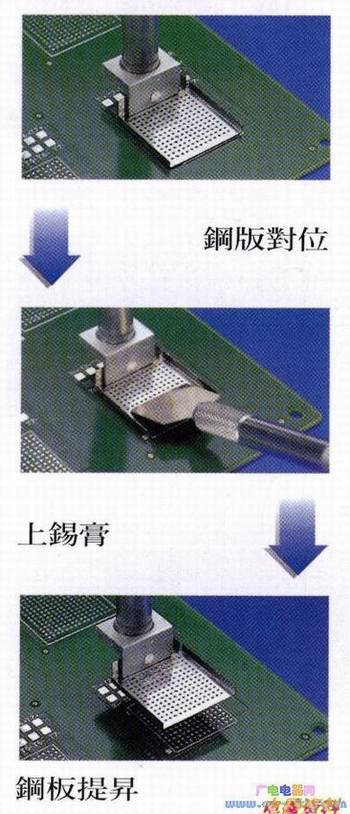
合适的小钢板,放置于焊垫上方。小钢板的厚度一般是在100um~200um之间,钢板尺寸限于周围零件所空出的区域大小。因此通常都只比大一点而已。
将所需要的锡膏印至上。
但通常Rework的状况下,并非得要上锡膏不可,在正常条件下,只要涂上一层Flux即可。
第二步:

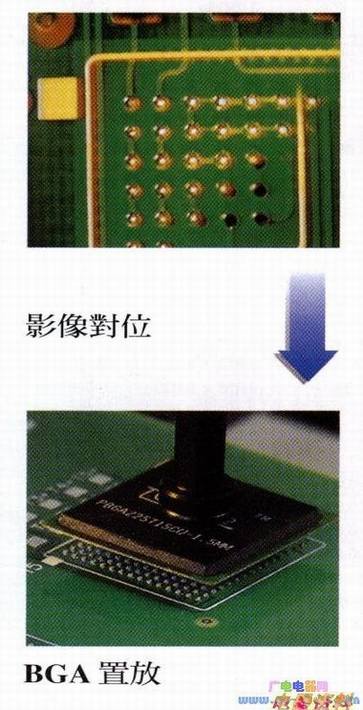
楷体使用影像对位可确保零件于Reflow时获得准确的焊接。
尤其是μBGA及对位时更需要依靠此功能。不像大尺寸BGA使用人工或机械对位有些许偏移,尚能因锡铅的内聚力而自动对位。
第三步:
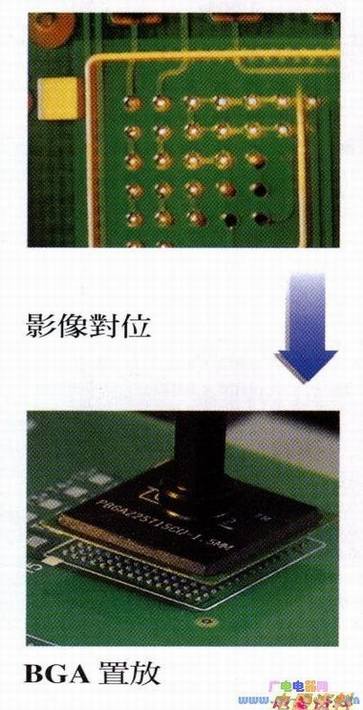

BGA的回焊对基板而言是以局步加热的方式进行,除依靠特殊设计之加热风罩外,尚须有底步加热器,协助零件下方基板的预热。其加热过程之Profile和正常Reflow相似。因此加热风罩的设计功能非常重要,尤其是不能因过热或不均而伤害到零件本身或周围的零件与基板。
- 上一篇:目视对位式的BGA元件维修系统作业方式
- 下一篇:燃气灶不点火的维修方法